ヒートシンクの選択方法

ヒートシンクは回路設計の重要な要素です。周囲の空気や電子装置(例 )から離れて熱が伝達されるため、効率的なパスを確保します。BJT、MOSFET、リニアレギュレータ、BGAパッケージなど)。ヒートシンクの背景にある一般的理論は、熱生成装置の表面積を増加させることにより、熱を周囲環境へ効率的に伝達することです。この改善された熱経路は、電子装置の接合部における温度上昇を低減します。以下の記事の目的は、アプリケーションの熱データとヒートシンクベンダーの仕様を使い、ヒートシンクの選択に関する高水準のプライマーを提供することです。
ヒートシンクは本当に必要ですか?
この記事の残りの部分で、アプリケーションがTO-220パッケージに格納されているトランジスタを使い開発されていると仮定します。トランジスタのスイッチング損失と導通損失は、電力損失2.78 Wに等しいため、このアプリケーションの温度は50℃を超えることはないと予測されます。このトランジスタにはヒートシンクが必要ですか?
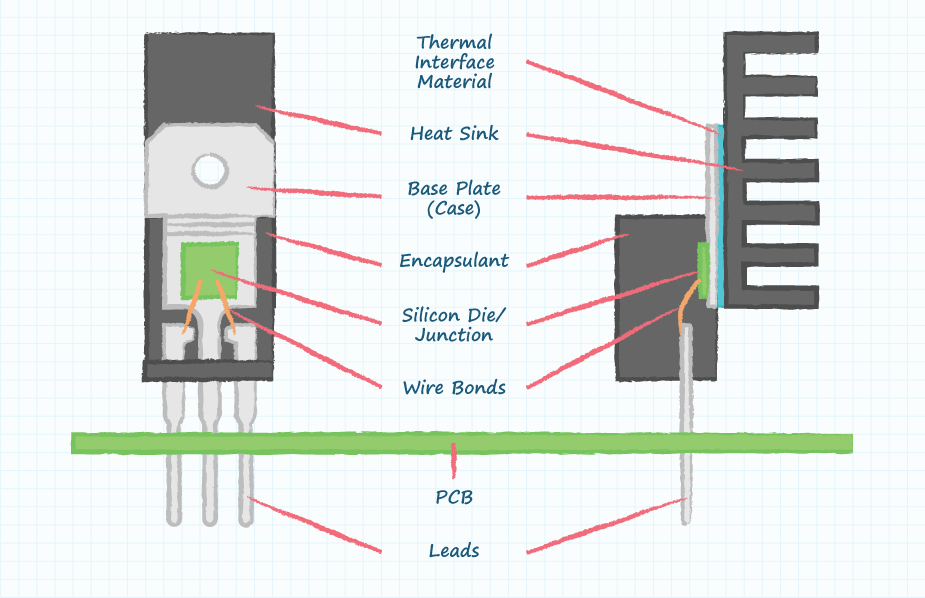
最初のステップは、周囲の空気中に2.78Wが放散されるのを妨ぐすべての熱インピーダンスを収集し把握することです。これらのワットを効率的に消散できない場合は、TO-220パッケージ内の接合部の温度は上昇し、推奨動作条件(通常シリコンの場合は125℃)を超えてしまいます。
ほとんどのトランジスタベンダーは、記号R θJ-A で示される「接合部から周囲へ」の熱インピーダンスを記録します。これは℃/ Wの単位で測定されます。この値は、デバイス内で放散される1ワットの電力に対して、接合部温度がTO-220パッケージの周辺の周囲温度よりどれだけ上昇するかを表しています。
例えば、トランジスタベンダーが接合部から周囲への熱インピーダンスが62℃/Wであると述べた場合、TO-220パッケージ内で放散される2.78 Wが接合部温度を周囲温度よりも172℃高く上昇させることを意味します。(2.78 W×62℃/Wとして計算)最悪の場合でこのアプリケーションの周囲温度が50℃と仮定すると、接合部温度は222℃に達します(50℃+ 172℃として計算)。これは125℃の定格シリコン温度をはるかに超えてしまい、トランジスタに永久的に損傷を与えます。このため、ヒートシンクが必要なのです。ヒートシンクを取り付けると、ジャンクションから周囲の熱インピーダンスが大幅に低下します。次のステップでは、安全性や信頼性の高い動作をするための熱インピーダンスパスをどれだけ低くする必要があるかを判断します。
熱インピーダンスパスの決定
この決定をするには、まず、許容最大温度上昇から始めます。アプリケーションの最大周囲温度が50℃で、シリコン接合部が125℃以下という条件を維持しなければならない場合、最大許容温度上昇は75℃(125℃〜50℃として計算)です。
次に、接合部と周囲空気の間の最大許容熱インピーダンスを計算します。最大許容温度上昇が75℃でTO-220パッケージで放散されるワットが2.78 Wである場合は、最大許容熱インピーダンスは27℃/Wとなります(75℃÷2.78 Wとして計算)。
最後に、シリコン接合部から周囲の空気までのすべての熱インピーダンスパスを合計して、この例では27℃/ Wである最大の許容熱インピーダンスよりも小さくなるようにします。

上記の図から、必要な最初の熱インピーダンスは、記号R θJ-C で示される「接合部からケース」です。これは、熱が発生している接合部からデバイスの表面(ケース)(この例ではTO-220)でどれぐらい容易に熱が伝達されるかを見る目安です。ほとんどのベンダーは、このインピーダンスを接合部から周囲メトリックとともにデータシートに記載します。この例では、想定される接合部からケース間の熱インピーダンスは0.5℃/Wとなります。
必要とされる第2の熱インピーダンスは、記号RθC-S で示される「ケースからシンク」であり、これは、デバイスの表面(ケース)からヒートシンクの表面に熱がどの程度容易に伝達されるかを見る目安です。TO-220ケースとヒートシンクベースの表面が不揃いであるため、サーマルインターフェース材質(TIMまたは「サーマルコンパウンド」)を使用して、熱面から完全に噛み合うようにすることを推奨します 。これにより、TO-220ケースからヒートシンクへの熱伝達が大幅に改善されますが、それに伴う熱インピーダンスを考慮する必要があります。
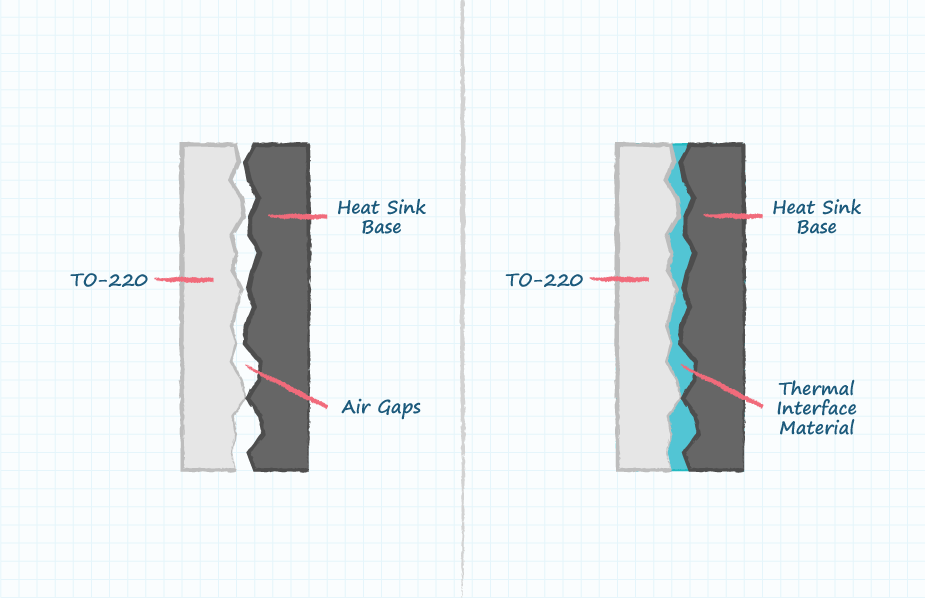
熱界面材料のアカウント
熱界面材料(TIM)は、通常はメートル/摂氏(W/(m℃))または ワット/メーター - ケルビン(W/(m K))に関して熱伝導率により特徴づけられます。この例では、摂氏とケルビンはどちらも同じ温度測定値で温度上昇/下降が計算されるため、相互互換です(例えば、45℃の温度上昇は、45Kの温度上昇)。TIMのインピーダンスは、面積(メートルでTIM材料の厚さ)の面積(TIMがメートル単位で広がる面積2)に依存するため、メートルの単位があり、結果は1/m(m /m2 = 1/ mとして計算)となります。熱界面材料の重要性ブログでTIMの詳細について議論していきます。この例では、TIMの薄層がTO-220ケースの金属タブ領域に適用されます。この例で使用される特定のTIMプロパティとアプリケーションの詳細は以下のとおりです。
TIMの熱伝導率(「K」):0.79 W/(m °C) = 0.79 W/(m K)
TIMのアプリケーション適用範囲:112 mm2 = 0.000112 m2
TIMのアプリケーションの厚さ:0.04 mm = 0.00004 m
TIMの熱インピーダンスは、以下の式を使い上記の特性から計算することができます(単位の一貫性を図るためにメートルを使用していることに注意してください)。
Rθ C-S = (厚さ / 範囲) x (1 / 伝導率)
Rθ C-S = (0.00004 / 0.000112) x (1 / 0.79)
Rθ C-S = 0.45 C/W または 0.45 K/W
ヒートシンクを選択する
必要な最終熱インピーダンスは記号RθS-Aで示される「シンクから周囲温度」です。これは、熱がヒートシンクのベースから周囲の空気にどれだけ容易に伝達されるかの目安です。CUI Devicesのようなヒートシンクベンダーは、通常、ヒートシンクから様々な空気流の条件や負荷の下で、どれぐらい容易に熱が周囲の空気に伝達されるのかを示すために、以下のようなグラフやデータポイントを提供します。
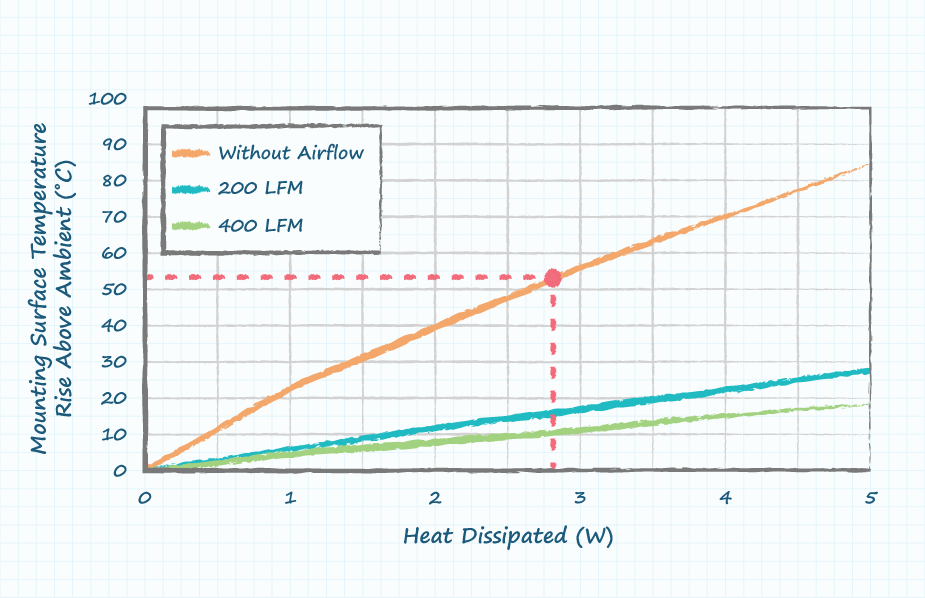
この例では、アプリケーションが空気流のない自然対流条件下で動作していると仮定しています。上記のグラフを使用して、この特定のヒートシンクの最終的な熱インピーダンス(シンクから周囲温度)を計算することができます。周囲温度より上昇した表面温度を熱放散で割り、特定の動作状態の熱インピーダンスを算出します。この例では、熱放散は2.78 Wであり、周囲温度よりも53℃高い表面温度上昇をもたらします。53℃を2.78 Wで割ると、シンクから周辺にかけての熱インピーダンスは19.1℃/W(53°C ÷ 2.78 Wと計算)になります。
前述の計算では、接合部と周囲空気との間に許容される最大インピーダンスは27℃/Wでした。接合部からケース間インピーダンス(0.5℃/ W)とケースからシンク(0.45℃/W)のインピーダンスを差し引くと、ヒートシンクに残される最大許容は26.05℃/W (27℃/ W~0.5℃/W~0.45℃/Wとして計算)。想定された条件下でのこのヒートシンクの19.1℃/Wの熱インピーダンスは、以前に計算された26.05℃/Wの許容値を大幅に下回ります。これはTO-220パッケージ内部のより低温のシリコン接合部の温度と設計上の熱マージンにつながります。接合部の最大温度は、すべての熱インピーダンスを合計し、接合部で放散されるワット数を掛けて、その結果を最大周囲温度に加算することで見積が算出できます。
推定接合部温度 = T周囲温度 + ワット x ( RθJ-C + Rθ C-S + Rθ S-A)
推定接合部温度 = 50 + 2.78 x ( 0.5 + 0.45 + 19.1)
推定接合部温度 = 105.7°C
ヒートシンクの重要性
この例でわかるように、ヒートシンクは温度管理の重要な要素です。ヒートシンク無しでは、TO-220パッケージ内のシリコン接合部は定格の125℃をはるかに超えてしまいます。この例で使用されているプロセスは簡単に変更したり、繰り返したりすることができ、様々なアプリケーションに合わせて適切なサイズのヒートシンクを設計者が選択できます。
主な取り組み
- ヒートシンクは、熱が周囲の空気や電子デバイスから離れて伝達する効率的なパスを提供するため、回路設計における重要な要素です。
- 周囲環境の最高温度とアプリケーション内で放散される電力を定義することは、ヒートシンクの選択を最適化するのに役立ちます。あまりにも小さいと燃え尽き、大きすぎると無駄にコストがかかることになります。
- Thermal Interface Materials(TIM)は、2つの表面間で熱をより効率的かつ一貫して伝達する上で重要な役割を果たします。
- アプリケーションのパラメータ(例えば、周囲温度、電力損失、熱インピーダンスパスなど)が定義されると、CUI Devicesのパラメトリック検索機能を使い、ジョブに適したボードレベルやBGAヒートシンクを見つけることができます。






